Halvledarlaserlyftutrustning revolutionerar götförtunning
Detaljerat diagram
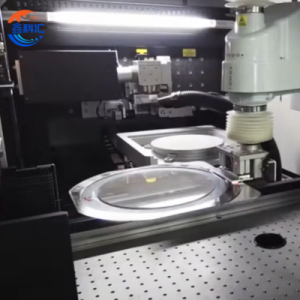
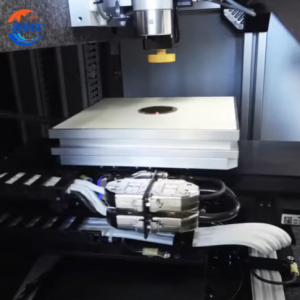
Produktintroduktion av halvledarlaserlyftutrustning
Halvledarlaserlyftutrustningen är en högspecialiserad industriell lösning konstruerad för exakt och beröringsfri gallring av halvledartackor genom laserinducerade lyfttekniker. Detta avancerade system spelar en avgörande roll i moderna halvledarwaferprocesser, särskilt vid tillverkning av ultratunna wafers för högpresterande kraftelektronik, lysdioder och RF-enheter. Genom att möjliggöra separation av tunna lager från bulktackor eller donatorsubstrat revolutionerar halvledarlaserlyftutrustningen götutgjutning genom att eliminera mekanisk sågning, slipning och kemisk etsning.
Traditionell gallring av halvledargöt, såsom galliumnitrid (GaN), kiselkarbid (SiC) och safir, är ofta arbetsintensivt, slösaktigt och benäget för mikrosprickor eller ytskador. Däremot erbjuder Semiconductor Laser Lift-Off Equipment ett icke-förstörande, precist alternativ som minimerar materialförlust och ytspänning samtidigt som produktiviteten ökar. Den stöder en mängd olika kristallina och sammansatta material och kan integreras sömlöst i front-end eller midstream halvledarproduktionslinjer.
Med konfigurerbara laservåglängder, adaptiva fokussystem och vakuumkompatibla waferchuckar är denna utrustning särskilt väl lämpad för götskärning, lamellskapande och ultratunn filmavskiljning för vertikala enhetsstrukturer eller heteroepitaxial lageröverföring.

Parameter för halvledarlaserlyftutrustning
| Våglängd | IR/SHG/THG/FHG |
|---|---|
| Pulsbredd | Nanosekund, pikosekund, femtosekund |
| Optiskt system | Fast optiskt system eller galvano-optiskt system |
| XY-scenen | 500 mm × 500 mm |
| Bearbetningsområde | 160 mm |
| Rörelsehastighet | Max 1 000 mm/sek |
| Repeterbarhet | ±1 μm eller mindre |
| Absolut positionsnoggrannhet: | ±5 μm eller mindre |
| Waferstorlek | 2–6 tum eller anpassad |
| Kontrollera | Windows 10, 11 och PLC |
| Strömförsörjningsspänning | AC 200 V ±20 V, Enfas, 50/60 kHz |
| Yttre mått | 2400 mm (B) × 1700 mm (D) × 2000 mm (H) |
| Vikt | 1 000 kg |
Arbetsprincip för halvledarlaserlyftutrustning
Kärnmekanismen för lyftutrustning för halvledarlasrar bygger på selektiv fototermisk sönderdelning eller ablation vid gränssnittet mellan donatorgötet och epitaxialskiktet eller målskiktet. En högenergi-UV-laser (vanligtvis KrF vid 248 nm eller fastfas-UV-lasrar runt 355 nm) fokuseras genom ett transparent eller halvtransparent donatormaterial, där energin absorberas selektivt på ett förutbestämt djup.
Denna lokaliserade energiabsorption skapar ett högtrycksskikt av gasfas eller termisk expansion vid gränssnittet, vilket initierar den rena delamineringen av det övre skiv- eller enhetsskiktet från gjutbasen. Processen finjusteras genom att justera parametrar som pulsbredd, laserfluens, skanningshastighet och z-axelns fokusdjup. Resultatet är en ultratunn skiva – ofta i intervallet 10 till 50 µm – som är rent separerad från modergjutet utan mekanisk nötning.
Denna metod för laserlyftning för götuttunning undviker den skärförlust och ytskada som är förknippad med diamanttrådsågning eller mekanisk läppning. Den bevarar också kristallintegriteten och minskar kraven på polering efteråt, vilket gör halvledarlaserlyftutrustning till ett banbrytande verktyg för nästa generations waferproduktion.
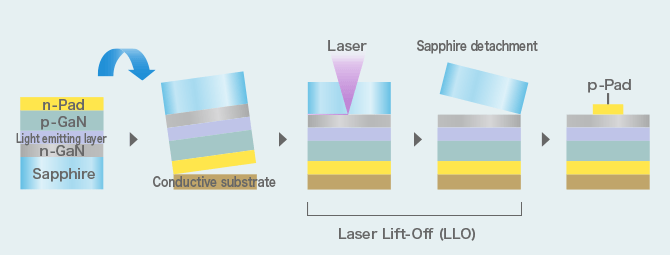
Tillämpningar av halvledarlaserlyftutrustning
Lyftutrustning för halvledarlasrar finner bred tillämpning vid götförtunning i en rad avancerade material och enhetstyper, inklusive:
-
GaN- och GaAs-götförtunning för kraftkomponenter
Möjliggör skapande av tunna wafers för högeffektiva effekttransistorer och dioder med låg resistans.
-
SiC-substratåtervinning och lamellseparation
Möjliggör lyftning i waferskala från bulk SiC-substrat för vertikala enhetsstrukturer och återanvändning av wafers.
-
LED-skivning av wafers
Underlättar lyftning av GaN-lager från tjocka safirtackor för att producera ultratunna LED-substrat.
-
Tillverkning av RF- och mikrovågsenheter
Stöder ultratunna HEMT-strukturer (high-electron-mobility transistor) som behövs i 5G- och radarsystem.
-
Epitaxiell lageröverföring
Lösgör exakt epitaxiella lager från kristallina tackor för återanvändning eller integration i heterostrukturer.
-
Tunnfilmssolceller och solceller
Används för att separera tunna absorberande lager för flexibla eller högeffektiva solceller.
Inom vart och ett av dessa områden ger halvledarlaserlyftutrustning oöverträffad kontroll över tjockleksuniformitet, ytkvalitet och lagerintegritet.
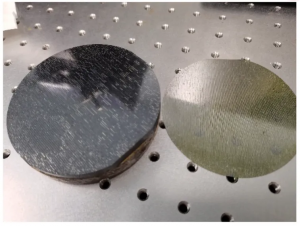
Fördelar med laserbaserad götförtunning
-
Materialförlust utan skärsnitt
Jämfört med traditionella waferskärningsmetoder resulterar laserprocessen i nästan 100 % materialutnyttjande.
-
Minimal stress och skevhet
Beröringsfri lyftning eliminerar mekaniska vibrationer, vilket minskar waferböjning och bildandet av mikrosprickor.
-
Bevarande av ytkvalitet
I många fall krävs ingen efterförtunning eller polering efter bearbetning, eftersom laserlift-off bevarar den övre ytans integritet.
-
Hög genomströmning och redo för automatisering
Kan bearbeta hundratals substrat per skift med automatiserad lastning/lossning.
-
Anpassningsbar till flera material
Kompatibel med GaN, SiC, safir, GaAs och nya III-V-material.
-
Miljömässigt säkrare
Minskar användningen av slipmedel och starka kemikalier som är typiska för slambaserade gallringsprocesser.
-
Återanvändning av substrat
Donatortackor kan återvinnas för flera lyftcykler, vilket avsevärt minskar materialkostnaderna.
Vanliga frågor (FAQ) om lyftutrustning för halvledarlasrar
-
F1: Vilket tjockleksområde kan halvledarlaserlyftutrustningen uppnå för waferskivor?
A1:Typisk skivtjocklek varierar från 10 µm till 100 µm beroende på material och konfiguration.F2: Kan den här utrustningen användas för att tunna ut göt gjorda av ogenomskinliga material som SiC?
A2:Ja. Genom att justera laservåglängden och optimera gränssnittstekniken (t.ex. offermellanlager) kan även delvis ogenomskinliga material bearbetas.F3: Hur justeras donatorsubstratet före laserlift-off?
A3:Systemet använder submikronbaserade visionsbaserade inriktningsmoduler med feedback från referensmarkeringar och ytreflektionsskanningar.F4: Vad är den förväntade cykeltiden för en laserlift-off-operation?
A4:Beroende på waferstorlek och tjocklek varar typiska cykler från 2 till 10 minuter.F5: Kräver processen en renrumsmiljö?
A5:Även om det inte är obligatoriskt rekommenderas renrumsintegration för att bibehålla substratrenhet och enhetsutbyte under högprecisionsoperationer.
Om oss
XKH specialiserar sig på högteknologisk utveckling, produktion och försäljning av specialoptiska glas och nya kristallmaterial. Våra produkter används inom optisk elektronik, konsumentelektronik och militären. Vi erbjuder optiska safirkomponenter, mobiltelefonlinsskydd, keramik, LT, kiselkarbid SIC, kvarts och halvledarkristallskivor. Med skicklig expertis och den senaste utrustningen utmärker vi oss inom icke-standardiserad produktbearbetning, med målet att vara ett ledande högteknologiskt företag inom optoelektroniska material.










