Glas blir snabbt enplattformsmaterialför terminalmarknader ledda avdatacenterochtelekommunikationInom datacenter ligger det till grund för två viktiga förpackningsbärare:chiparkitekturerochoptisk ingång/utgång (I/O).
Desslåg värmeutvidgningskoefficient (CTE)ochdjup ultraviolett (DUV)-kompatibla glasbärarehar aktiverathybridbindningoch300 mm tunnskivsbaksidesbearbetningatt bli standardiserade tillverkningsflöden.
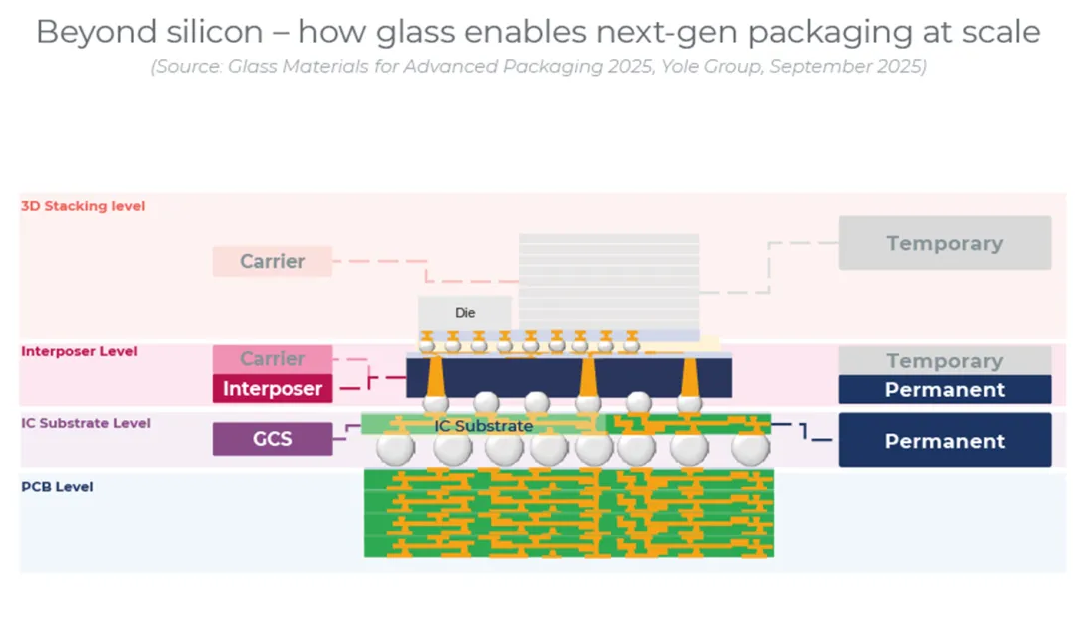
Allt eftersom switch- och acceleratormoduler växer bortom wafer-stepper-dimensioner,panelbärareblir alltmer oumbärliga. Marknaden förglaskärnsubstrat (GCS)beräknas nå460 miljoner dollar till 2030, med optimistiska prognoser som tyder på att det införs allmänt runt2027–2028Under tiden,glasmellanläggförväntas överstiga400 miljoner dollaräven under konservativa prognoser, ochstabilt glasbärarsegmentrepresenterar en marknad på cirka500 miljoner dollar.
In avancerad förpackning, glas har utvecklats från att vara en enkel komponent till att bli enplattformsverksamhetFörglasbärare, intäktsgenerering flyttas frånprissättning per panel to ekonomi per cykel, där lönsamheten beror pååteranvändningscykler, laser/UV-avbindningsutbyten, processutbyteochminskning av kantskadorDenna dynamik gynnar leverantörer som erbjuderCTE-graderade portföljer, paketleverantörersäljer integrerade staplar avbärare + lim/LTHC + avbindningochregionala återvinningsleverantörerspecialiserar sig på optisk kvalitetssäkring.
Företag med djupgående expertis inom glas – som till exempelPlan Optik, känd för sinabärare med hög planhetmedkonstruerade kantgeometrierochkontrollerad transmission—är optimalt positionerade i denna värdekedja.
Glaskärnsubstrat frigör nu tillverkningskapaciteten för bildskärmar till lönsamhet genomTGV (Genom glas via), fin RDL (omfördelningslager)ochuppbyggnadsprocesserMarknadsledarna är de som behärskar de kritiska gränssnitten:
-
Högavkastande TGV-borrning/etsning
-
Porrfri kopparfyllning
-
Panellitografi med adaptiv justering
-
2/2 µm V/S (linje/mellanrum)mönstring
-
Tekniker för hantering av paneler som kan styras med warp
Substrat- och OSAT-leverantörer som samarbetar med tillverkare av displayglas konverterarstor ytkapacitettillkostnadsfördelar för förpackning i panelstorlek.

Från transportör till fullfjädrat plattformsmaterial
Glas har förvandlats från entillfällig transportörin i enomfattande materialplattformföravancerad förpackning, i linje med megatrender somchiplet-integration, panelisering, vertikal staplingochhybridbindning—samtidigt som budgetarna stramar åt förmekanisk, termiskochrenrumprestanda.
Som enbärare(både wafer och panel),transparent glas med låg CTEmöjliggörstressminimerad uppriktningochlaser/UV-avbindning, vilket förbättrar avkastningen förwafers under 50 µm, baksidesprocessflödenochrekonstruerade paneler, vilket uppnår kostnadseffektivitet vid flera användningsområden.
Som englaskärnsubstrat, den ersätter organiska kärnor och stödtillverkning på panelnivå.
-
TGV:erge tät vertikal kraft- och signalvägning.
-
SAP RDLtänjer på gränserna för kabeldragning2/2 µm.
-
Plana, CTE-avstämbara ytorminimera skevhet.
-
Optisk transparensförbereder underlaget försampaketerad optik (CPO).
Under tiden,värmeavledningutmaningar hanteras genomkopparhyvlar, sydda vias, baksidesströmförsörjningsnätverk (BSPDN)ochdubbelsidig kylning.
Som englasmellanlägg, materialet lyckas under två distinkta paradigmer:
-
Passivt läge, vilket möjliggör massiva 2,5D AI/HPC- och switcharkitekturer som uppnår ledningsdensitet och bump-antal som är ouppnåeliga med kisel till jämförbar kostnad och yta.
-
Aktivt läge, integrerandeSIW/filter/antennerochmetalliserade diken eller laserskrivna vågledareinuti substratet, vika RF-vägar och dirigera optiska I/O till periferin med minimal förlust.
Marknadsutsikter och branschdynamik
Enligt den senaste analysen avYole-gruppen, glasmaterial har blivitcentralt för halvledarkapslingsrevolutionen, driven av viktiga trender inomartificiell intelligens (AI), högpresterande datoranvändning (HPC), 5G/6G-anslutningochsampaketerad optik (CPO).
Analytiker betonar att glasetsunika egenskaper—inklusive desslåg CTE, överlägsen dimensionsstabilitetochoptisk transparens—göra det oumbärligt för att uppfyllamekaniska, elektriska och termiska kravav nästa generations paket.
Yole noterar vidare attdatacenterochtelekomförbli denprimära tillväxtmotorerför glasanvändning i förpackningar, medanbil-, försvarochavancerad konsumentelektronikbidra med ytterligare momentum. Dessa sektorer är alltmer beroende avchiplet-integration, hybridbindningochtillverkning på panelnivå, där glas inte bara förbättrar prestandan utan också minskar den totala kostnaden.
Slutligen, framväxten avnya leveranskedjor i Asien—särskilt iKina, Sydkorea och Japan—identifieras som en viktig möjliggörare för att skala upp produktionen och stärkaglobalt ekosystem för avancerade förpackningsglas.
Publiceringstid: 23 oktober 2025
