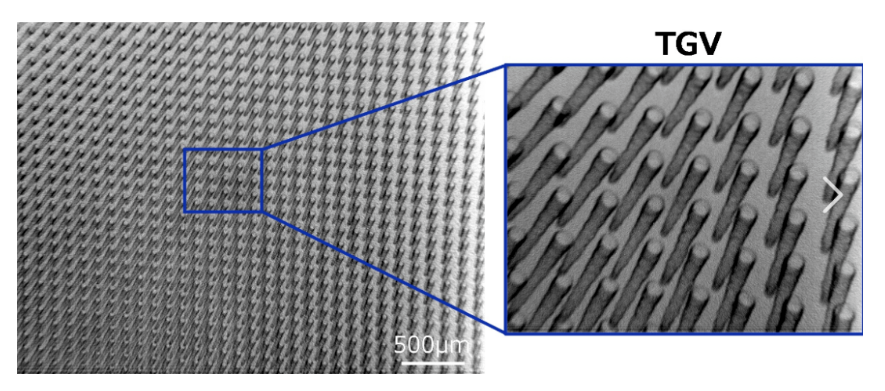
Vad är TGV?
TGV, (Genomgående glas via), en teknik för att skapa genomgående hål på ett glassubstrat. Enkelt uttryckt är TGV en höghusbyggnad som stansar, fyller och ansluter upp och ner i glaset för att bygga integrerade kretsar på glasgolvet. Denna teknik anses vara en nyckelteknik för nästa generations 3D-förpackning.

Vilka är kännetecknen för TGV?
1. Struktur: TGV är ett vertikalt penetrerande ledande genomgående hål tillverkat på ett glassubstrat. Genom att avsätta ett ledande metallskikt på porväggen sammankopplas de övre och nedre lagren av elektriska signaler.
2. Tillverkningsprocess: TGV-tillverkning omfattar förbehandling av substrat, håltillverkning, avsättning av metalllager, hålfyllning och utplattande steg. Vanliga tillverkningsmetoder är kemisk etsning, laserborrning, elektroplätering och så vidare.
3. Användningsfördelar: Jämfört med traditionella metallgenomgående hål har TGV fördelarna med mindre storlek, högre ledningstäthet, bättre värmeavledningsprestanda och så vidare. Används ofta inom mikroelektronik, optoelektronik, MEMS och andra områden med högdensitetssammankoppling.
4. Utvecklingstrend: Med utvecklingen av elektroniska produkter mot miniatyrisering och hög integration får TGV-tekniken alltmer uppmärksamhet och tillämpning. I framtiden kommer tillverkningsprocessen att fortsätta att optimeras, och dess storlek och prestanda kommer att fortsätta att förbättras.
Vad är TGV-processen?
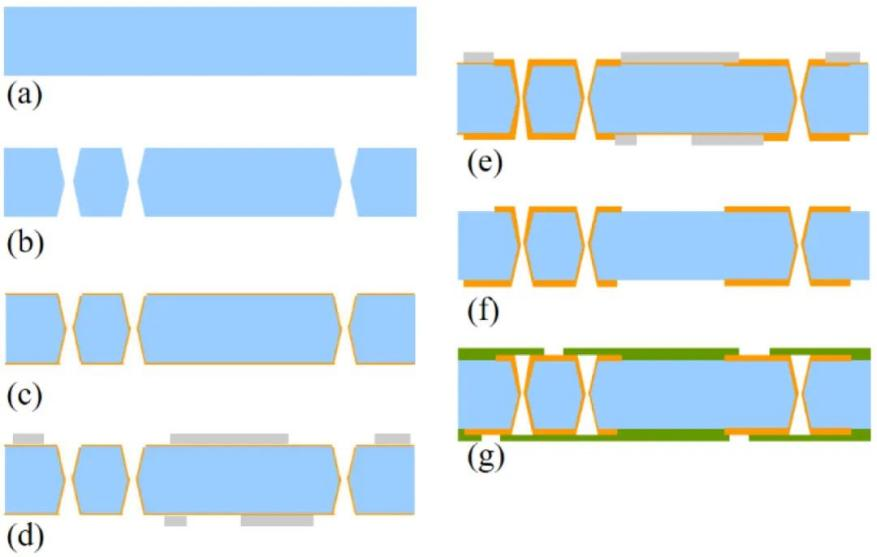
1. Förberedelse av glassubstrat (a): Förbered ett glassubstrat från början för att säkerställa att ytan är slät och ren.
2. Glasborrning (b): En laser används för att forma ett penetrationshål i glassubstratet. Hålets form är vanligtvis konisk, och efter laserbehandling på ena sidan vänds det och bearbetas på den andra sidan.
3. Hålväggsmetallisering (c): Metallisering utförs på hålväggen, vanligtvis genom PVD, CVD och andra processer för att bilda ett ledande metallfröskikt på hålväggen, såsom Ti/Cu, Cr/Cu, etc.
4. Litografi (d): Ytan på glassubstratet beläggs med fotoresist och fotomönstras. Exponera de delar som inte behöver pläteras, så att endast de delar som behöver pläteras exponeras.
5. Hålfyllning (e): Elektroplätering av koppar för att fylla glasets genomgående hål för att bilda en komplett ledande bana. Det krävs generellt att hålet är helt fyllt utan hål. Observera att Cu i diagrammet inte är helt befolkat.
6. Substratets plan yta (f): Vissa TGV-processer plattar ut ytan på det fyllda glassubstratet för att säkerställa att substratets yta är slät, vilket gynnar de efterföljande processstegen.
7. Skyddsskikt och terminalanslutning (g): Ett skyddande skikt (såsom polyimid) bildas på ytan av glassubstratet.
Kort sagt, varje steg i TGV-processen är avgörande och kräver exakt kontroll och optimering. Vi erbjuder för närvarande TGV-glasgenomgångsteknik vid behov. Kontakta oss gärna!
(Informationen ovan är hämtad från internet, censurerad)
Publiceringstid: 25 juni 2024
